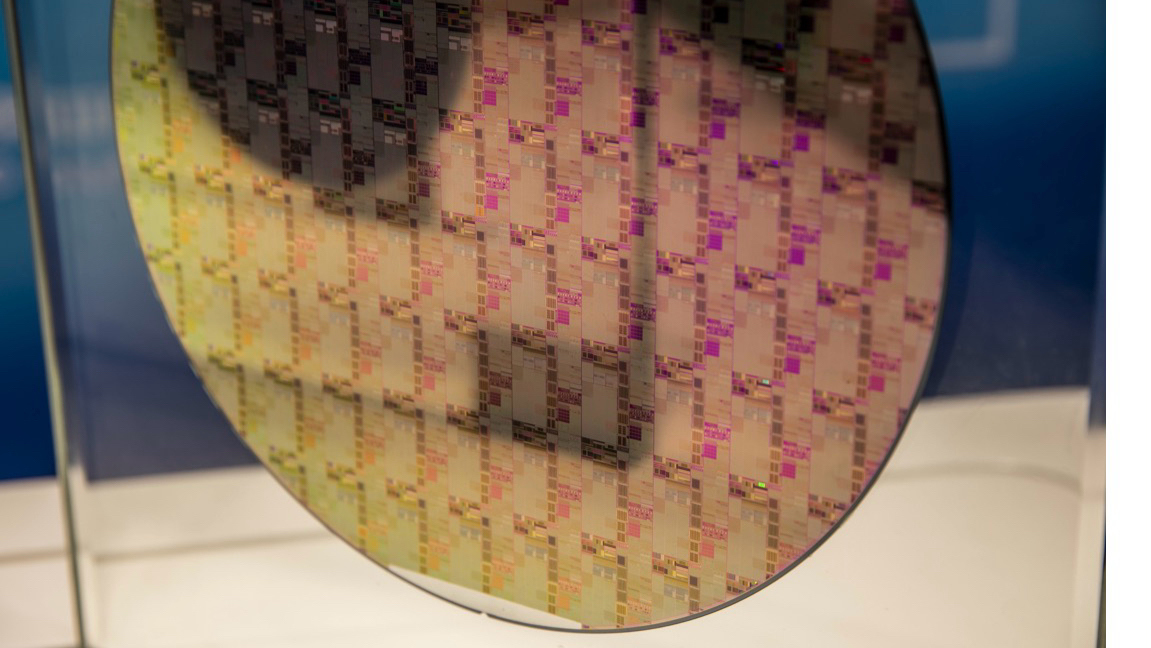
研究者称,需要在极紫外光刻胶领域进行提前布局,追赶国际同行的步伐。
10月27日,多只光刻胶概念股飘红,收盘万润股份涨停,晶瑞电材涨超16%,艾森股份涨超6%,南大光电涨超5%,彤程新材涨超4%。消息面上,国内研究团队在光刻胶领域取得了新的研究突破。
近日,北京大学化学与分子工程学院彭海琳教授团队及合作者撰写的一篇论文发表在《自然·通讯》上,引起了广泛关注。这篇论文将冷冻电子断层扫描技术(Cryo-ET)引入半导体领域,通过该技术在原位状态下解析了光刻胶分子在液相环境中的微观三维结构、界面分布与缠结行为,并指导开发出可显著减少光刻缺陷的产业化方案。该论文提出的方案,能使光刻技术在减少图案缺陷方面取得大于99%的改进。
在接受第一财经记者采访时,彭海琳表示,该研究成果可直接用于半导体制造,技术方案可行,与现有的装备兼容。
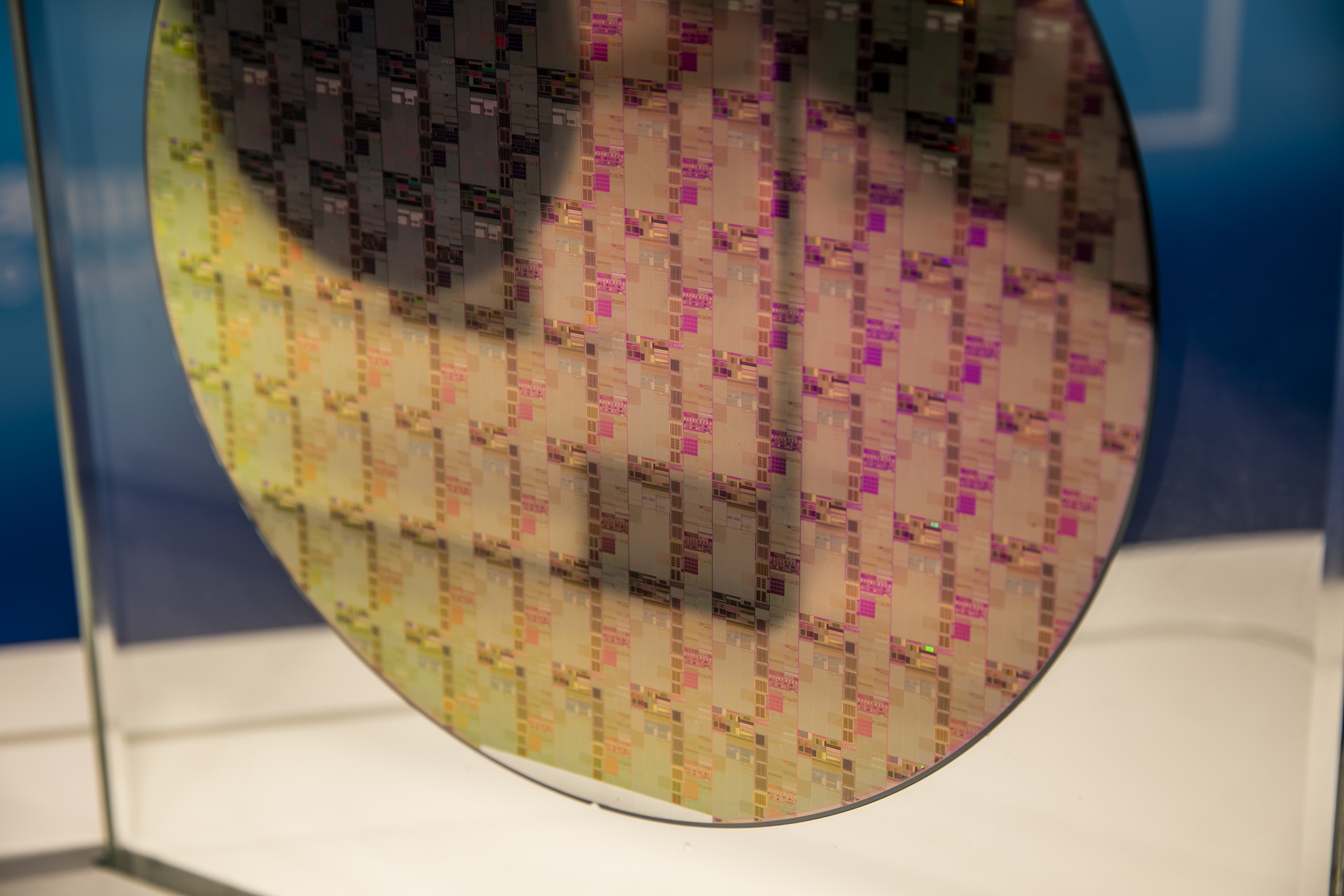
显著减少光刻缺陷
光刻胶即光致抗蚀剂,是半导体光刻过程中一种关键材料,在光刻工艺过程中用作抗腐蚀涂层材料。
简单理解,光刻是利用光和光刻胶之间的化学反应,采用深紫外光、极紫外光等将掩膜上的图案转移到硅晶圆上。光刻胶显影是通过显影液溶解曝光后光刻胶可溶解区域,形成纳米级电路图案,这一步骤直接影响集成电路的尺寸精度。然而,光刻胶在显影液中的行为长期是“黑匣子”,产业界在进行工艺优化时只能反复试错,阻碍了大批量制造时的技术优化,成为制约7纳米及更先进制程良率提升的瓶颈之一。
“随着图案的特征尺寸接近光刻胶聚合物的轮廓长度,液膜内光刻胶分子的吸附和纠缠行为成为控制图案缺陷形成的关键因素,最终决定半导体器件的稳定性和良率。”这篇名为《Cryo-electron tomography reconstructs polymer in liquid film for fab-compatible lithography》(冷冻电子断层扫描重建液膜中的聚合物以实现与半导体制造兼容的光刻技术)的论文称,然而,尽管经过数十年的研究,光刻胶在液膜以及在气液界面处的微观行为仍难以捉摸,导致产业界在控制图案缺陷方面基本上是一个不断试错的过程。
彭海琳告诉记者,此前业内主要通过扫描电子显微镜、原子力显微镜等技术表征光刻图案,这些技术受限于“与液体环境不兼容”或“较低的分辨率”,导致光刻胶在液膜中的微观结构和界面行为不清楚。
彭海琳及北京大学教授高毅勤、博士郑黎明、清华大学教授王宏伟、香港大学博士刘楠等在该项研究中,则采用Cryo-ET技术,揭示了光刻胶聚合物在液膜和气液界面处的纳米结构和动态特性,将气液界面处光刻胶聚合物的空间分布细化到溶液本体,并揭示了聚合物链之间的结合缠结现象,这种方法与传统方法相比具有更高分辨率。研究人员合成出一张分辨率优于5纳米的微观三维“全景照片”。
该论文进一步提出,在光刻胶显影过程中抑制聚合物缠结,可能是缓解图案表面缺陷形成的关键。在光刻过程中提高曝光后烘烤(PEB)温度可以有效抑制聚合物缠结。当PEB温度升高到105°C时,光刻胶聚合物倾向于解缠和分离,轮廓长度缩短。该论文还建议在整个光刻胶显影过程中使用连续的液膜,以确保在气液界面处可靠地捕获解缠结的聚合物,并防止其重新沉积。
“通过这种策略,可以在整个12英寸晶圆上消除聚合物残留物造成的缺陷。”该论文称,12英寸晶圆表面的光刻胶残留物引起的图案缺陷被成功消除,缺陷数量降幅超过99%,同时,该策略与现代晶圆厂兼容,现有设施可在技术上实现抑制光刻胶缠结和连续液膜。
“需在极紫外光刻胶领域提前布局”
交叉学科研究在这项研究中起到了较为关键的作用。在这项研究中,研究者首次将冷冻电子断层扫描技术引入半导体领域。向记者谈及该技术的使用时,彭海琳表示,Cryo-ET技术此前主要用于结构生物学,“近期斯坦福大学研究人员将其应用于电池领域,我们将Cryo-ET技术应用于光刻领域也是一种跨学科交叉研究。”
彭海琳表示,他所在的课题组与清华大学生命学院一直密切合作,开发高分辨冷冻电镜成像技术有较好的研究基础。课题组内学科交叉,不同领域的研究人员容易碰撞出火花,很自然就想到用Cryo-ET技术来解析溶液中的光刻胶高分子。
记者留意到,在光刻胶研究领域,近两年国内学界取得了一些重要的研究进展,而且一些研究成果已经在赋能半导体制造。
除了彭海琳教授团队及合作者的最新研究成果,今年7月,清华大学还表示,该校化学系许华平教授在极紫外(EUV)光刻材料上取得了重要进展,开发出一种基于聚碲氧烷的新型光刻胶,有望推动下一代EUV光刻材料的发展。
去年,复旦大学高分子科学系、聚合物分子工程国家重点实验室魏大程团队则设计了一种功能型光刻胶,利用光刻技术在全画幅尺寸芯片上集成了2700万个有机晶体管并实现了互连,可助力实现特大规模集成度有机芯片制造,该团队表示“在积极寻求产业界合作,推动科研成果应用转化”。去年华中科技大学还与湖北九峰山实验室组成联合研究团队,突破了“双非离子型光酸协同增强响应的化学放大光刻胶”技术,这一具有自主知识产权的光刻胶体系已在生产线上完成了初步工艺验证,实现了从技术开发到成果转化全链条打通。
就如何进一步减少半导体制造领域的制造缺陷、如何看未来研究方向,彭海琳向记者表示,需要由产业界提需求,学术界进行基础研究并反馈给产业界。
随着集成电路工艺演进,光刻机也从DUV(深紫外光刻机)演变到能生产7nm及更先进制程的EUV(极紫外光刻机)。就中国学者在光刻胶相关研究领域所处的位置,彭海琳告诉记者,国际同行早在2000年左右就对深紫外光刻胶和极紫外光刻胶进行了大量的研究,国内学者目前处于努力追赶的状态。
据市场研究机构QYResearch数据,2024年全球半导体光刻胶市场规模约26.85亿美元,预计2031年将达45.47亿美元。光刻胶核心厂商包括东京应化 TOK、JSR、信越化学Shin – Etsu等,主要来自日本、美国和韩国,2023 年前五大厂商约占86%市场份额,国内企业则已在部分中低端产品领域取得突破,并投入EUV光刻胶研发,推动光刻胶国产化进程。
就半导体光刻技术突破还需要在什么研究领域发力,彭海琳告诉记者,国内目前虽然在光刻机领域有所受限,但仍需要在极紫外光刻胶领域进行提前布局,追赶国际同行的步伐。

